Introducción
Uno de los semiconductores más estudiados en la tecnología actual es el arseniuro de galio (GaAs), debido a sus aplicaciones en micro y nano electrónica moderna en dispositivos de alta frecuencia, láseres que emiten en el infrarrojo y fabricación de celdas solares de tercera generación. La investigación de semiconductores como GaAs está enfocada al crecimiento de cristales de GaAs por técnicas epitaxiales como MBE, LPE ó MOCVD, y en mucha menor proporción usando métodos de preparación de policristales con técnicas de menor costo (en comparación con técnicas epitaxiales) como magnetrón sputtering (MS), la cual permite depositar capas de GaAs sobre substratos de vidrio amorfo y silicio orientado (001) [1,2]. El depósito de GaAs sobre substratos de silicio es de gran interés para realizar una integración con la tecnología actual del silicio en el desarrollo de la industria fotovoltaica y en algunos dispositivos optoelectrónicos [3]. El crecimiento de GaAs sobre un substrato de Silicio (Si) se ha reportado por técnicas de deposición como ablación láser pulsado (PLD) obteniendo aleaciones con orientación cristalográfica a lo largo de la dirección (111). Por MS se reporta que GaAs tiene una estructura amorfa en la mayoría de casos, debido a la formación de fases secundarias [4,5]. Algunos otros reportes indican que un recocido térmico a una temperatura de 260 °C en una atmósfera inerte, mejora la calidad estructural obteniendo una orientación preferencial en la dirección (111) [6].
Por otro lado, si en la matriz de GaAs los átomos de Ga se sustituyen con átomos de Mn+2, el semiconductor adquiere propiedades semi-magnéticas importantes para aplicaciones en dispositivos espintrónicos de tercera generación. En este caso el Mn actúa como un aceptor, proporcionando un momento magnético, resultado de la polarización de los orbitales semi-llenos 3d del espín electrónico. La energía del nivel aceptor que está 0.113 eV por arriba del borde de la banda de valencia, posiblemente contribuye al intercambio ferromagnético. Sin embargo, teorías más recientes sugieren significativas modificaciones en las propiedades ferromagnéticas de estas aleaciones si los huecos residen en una banda de impurezas fuertemente desordenada.
Las aleaciones semiconductoras III-V dopadas con Mn, muestran ser muy sensibles a las condiciones de preparación y al contenido de Mn en la matriz III-V. Un ejemplo, es el GaAsMn/GaAs(100) preparado por epitaxia de haces moleculares que con una concentración optima de 6 %, que alcanza una temperatura de Curie (Tc) máxima de 140 K, que depende fuertemente de las condiciones de crecimiento. Otros reportes interesantes para aplicaciones tecnológicas indican que hetero-uniones epitaxiales de GaAsMn/MnAs presentan una temperatura de Curie por encima de temperatura ambiente (Tc = 325 K) debido a la formación de la fase ferromagnética de MnAs en la interface de la hetero-estructura [7]. Sin embargo, el ferromagnetismo en estos materiales es aún muy discutido. La búsqueda de condiciones experimentales para la fabricación de aleaciones semi-magnéticas de GaAsMn por pulverización catódica asistida por campo magnético con una temperatura de Curie por encima de 140 K es un reto para la física y la tecnología, debido a la dificultad de depositar capas de GaAs con bajos contenidos de Mn y de muy buena calidad estructural por técnicas no epitaxiales.
En este sentido presentamos los resultados del crecimiento y caracterización de capas de GaAs y aleaciones semi-magnéticas de GaAsMn depositadas por pulverización catódicas asistida por campo magnético sobre un substrato de silicio (100). Las capas de GaAs y GaAsMn fueron caracterizadas mediante rayos X, microscopía de fuerza atómica (MFA), espectroscopia Raman, espectroscopia de masa de iones secundarios (SIMS) en perfil de profundidad, y magnetometría de muestra vibrante (VSM).
Detalles experimentales
Las capas de GaAs y GaAsMn fueron obtenidas por magnetrón sputtering r.f. sobre substratos de Silicio (limpiados y desengrasados por métodos convencionales) en una atmósfera de argón a una presión de 5×10-3 Torr por 60 minutos y a una temperatura de 580 °C. Durante el proceso de deposición se empleó un blanco de GaAs de dos pulgadas de diámetro y uno de Mn de una pulgada, respectivamente. Para el depósito de GaAs se utilizó una potencia de 30 Watt. La capa de GaAsMn se realizó por co-evaporación utilizando una potencia de 30 Watt para el blanco de GaAs y de 15 Watt para el blanco de Mn. La caracterización estructural de cada una de las capas se realizó utilizando difracción de rayos X en un equipo Panalytical Xpert pro, equipado con una fuente de radiación de Cu-Kα (λ = 1.540562 Å) a una velocidad de 1 °/min, en un rango de 20 ≤ 2θ ≤ 60. Las medidas de microscopía Raman se realizaron utilizando una configuración de retrodispispersión, en dirección perpendicular a la muestra, utilizando la línea 632.8 nm de un láser de He-Ne, en un espectrómetro LabRAM Dilor XY, equipado con un microscopio Olympus BX40. La caracterización morfológica se hizo por microscopia electrónica de barrido de emisión de campo (FE-SEM) a diferentes aumentos, en un equipo JEOL JSM740 1F. Las imágenes topográficas AFM de las capas se reconstruyeron con un microscopio de fuerza atómica Bruker Nano's N8 NEOS, el cantiléver utilizado fue un PPP-NCLR con frecuencia de resonancia de 190 kHz y una constante de fuerza de 48 nN/m y una velocidad de escaneo de 0.7 l/s. Las medidas SIMS se realizaron sobre un área de barrido 100 μm2 en un equipo SIMS-IMS GF el cual está equipado con un haz primario de energía 5 keV y con un ángulo aproximado de 45 ° con respecto a la muestra. Los iones secundarios CsM+ (M es el elemento de interés) se analizaron mediante un espectrómetro de masas con enfoque doble y equipado con un fotomultiplicador. Las medidas XPS se obtuvieron en un equipo Alpha 10 Hemisphrical Analyser equipado con un sistema de alto vacío, un analizador semiesférico, un cañón de rayos X con configuración de doble ánodo de Mg-Kα y Al-Kα el cual proporciona energías de 1253.6 eV y 1486.6 eV, respectivamente. El análisis magnético se realizó en un equipo comercial de magnetometría de muestra vibrante (VSM-VersaLab, Quantum Design), con el que se hicieron medidas de magnetización vs temperatura desde 50 K hasta 300 K a un campo aplicado de 500 Oe, usando los procesos de enfriamiento a campo nulo ZFC (Zero Field Cooling) y enfriamiento con campo aplicado FC (Field Cooling).
Resultados
Capa de GaAs depositada sobre Si (100)
Difracción de rayos X se utilizó para determinar la fase de la capa de arseniuro de galio (GaAs) depositada sobre un substrato de Si (100). La capa presenta un estructura cubica tipo zinc blenda (ZB) con una constante de red (a = 5.65 Å) y una orientación preferencial a lo largo de la dirección (111) como lo ilustra la Figura 1 (el plano principal (004) de reflexión del Silicio no se muestra en el difractograma). Tomando el plano (111) localizado en 2θ = 22.3 °, se determinó el ancho a la altura media (β = 0.375) para calcular el tamaño del cristalito (D = 27.7 nm) a partir de la fórmula de Scherrer (β = kλ/DCosθ) donde k = 0.9 y λ = 0.154 nm, correspondiente a la radiación Ka de una fuente de Cu [8]. El valor de β indica que la capa tiene una buena calidad cristalina. El plano (002) localizado en 2θ = 32.5 ° se atribuye a una capa superficial de SiO, debido a que este plano también aparece en el difractograma del substrato de Si tomado como referencia (Figura 1). Con el fin de determinar la textura cristalográfica de la capa de GaAs se tomó una figura de polos tridimensional (pole figure-3D), en la cual un eje (ó polo) cristalográfico de un número representativo de cristales son trazados en una proyección estereográfica, junto con sus direcciones cristalográficas relevantes. En esta figura el ancho del perfil es una figura de mérito del grado de texturización de la muestra. En el recuadro de la Figura 1 se muestra el diagrama de polos - 3D de la capa de GaAs tomada alrededor de 2θ = 27.26 °, corroborando que la muestra tiene una orientación preferencial, sin fases secundarias presentes en la capa.

Figura 1 Difractograma de rayos X de la capa de GaAs depositada sobre un sustrato de Si (100) (a) y de un substrato de Silicio (100) tomado como referencia (b). El inset muestra el diagrama de polos - 3D, en un ángulo de difracción de 2θ = 27.26 °.
En experimentos de dispersión Raman, las intensidades de dispersión pueden calcularse a partir del tensor Raman, el cual depende de la simetría del cristal
donde R ji es el tensor Raman, e (i) y e (s) son los vectores unitarios de polarización de la luz incidente y dispersada, respectivamente, y A es una constante determinada por el tipo de material y la frecuencia de dispersión. Para la estructura zinc blenda tal como GaAs, los modos vibracionales TO y LO dependen de la orientación del cristal y de la geometría de dispersión. Si la geometría utilizada es de retrodispersión z(x, x)𝑧̅,, y la orientación del cristal es (001), sólo el modo LO es permitido, mientras que el modo TO es prohibido debido a la naturaleza polar del cristal. Si el cristal tiene una dirección diferente a la (001), los modos LO y TO son permitidos debido a la pérdida de simetría del cristal [9,10]. En particular, si el cristal tiene orientación (111) la intensidad del modo TO es mayor que la del modo LO debido a la no conservación del vector de onda por la dispersión elástica de los portadores debido a defectos del cristal.
Para corroborar la calidad cristalina de la capa de GaAs depositada sobre un substrato de Si (001) y determinada mediante rayos X, se realizó espectroscopia Raman utilizando configuración de retrodispersión. Con el fin de evitar al máximo la dispersión Raman del sustrato, se utilizó la línea de 632.8 nm de un láser de He-Ne como fuente de luz de excitación, con una potencia de 20 Watt, y una longitud de penetración δ = λ/(4πk) = 250 nm. La Figura 2 ilustra el espectro Raman de la capa de GaAs/Si(100), en donde se observa que la intensidad integrada del modo TO (260.5 cm-1) es mayor que la del modo LO (285.14 cm-1), de acuerdo con la relación ITO/ILO = 3.3, lo cual es congruente con las reglas de selección. El corrimiento observado en los modos TO y LO del GaAs (111) respecto al de un cristal de GaAs (111), está asociado a esfuerzos inducidos al momento de la preparación de la capa debido al desacople de los parámetros de las redes capa-substrato y por efectos térmicos entre otros [11,12]. Estos efectos Raman han sido reportados para semiconductores con estructura cristalina y policristalina [13].
La imagen de MFA tomada sobre la superficie de la capa de GaAs en un área de 1×1 μm2 (Figura 3), se empleó para analizar la topografía en la superficie, con el fin de determinar el valor de la rugosidad promedio y el tamaño de partícula. De acuerdo con esta imagen, la superficie es homogénea con una rugosidad promedio RMS = 0.35 y un tamaño de partícula promedio Ps = 6 nm. La altura máxima estimada del perfil de altura vs la longitud a lo largo de la muestra fue de ≈ 2 nm.
Mediante un análisis de energía dispersiva de rayos X (EDS) realizado en la superficie y en sección transversal de la muestra, se determinó la composición estequiométrica de la capa de GaAs. La Tabla 1 muestra los porcentajes atómicos obtenidos para la capa de GaAs/Si(100). La distribución de los elementos en la superficie de las capa se corroboró mediante mapeos composicionales de As y Ga, mostrando una buena homogeneidad sobre el área analizada. Los valores obtenidos en porcentaje tanto en sección trasversal como en la superficie no difieren significativamente y están dentro del error experimental (~ 1 %).
Tabla 1 Porcentaje atómico de Ga y As determinado a partir de un análisis EDS en la superficie y en sección transversal, en la capa de GaAs/Si(100).
| Superficial | Sección transversal | |||
|---|---|---|---|---|
| Capa | As (%) | Ga (%) | As (%) | Ga (%) |
| GaAs | 51.5 | 48.5 | 52.9 | 47.1 |
| As (%) | Ga (%) | Mn (%) | ||
| GaAsMn | 50.0 | 42.0 | 8.0 | |
Un análisis complementario fue realizado mediante espectroscopia de masas de iones secundarios en perfil de profundidad (SIMS) con el fin de corroborar la homogeneidad de la capa de GaAs. La Figura 4 muestra el perfil de profundidad de la capa GaAs/Si(100), donde se puede observar que el porcentaje atómico (%) de cada uno de los elementos es aproximadamente 50 %, verificando que la capa de GaAs es estequiométrica. Por arriba de los 680 nm (interface capa-substrato) se observa una fuerte caída del Ga y As y un aumento de la señal de Si, indicando que la interface del semiconductor está muy bien definida, lo cual es un indicativo que la capa tiene una buena calidad estructural. No se observó la formación de gotas o clústeres ricos en Ga o As a lo largo de la capa, mostrando que solo se generan enlaces entre Ga y As.
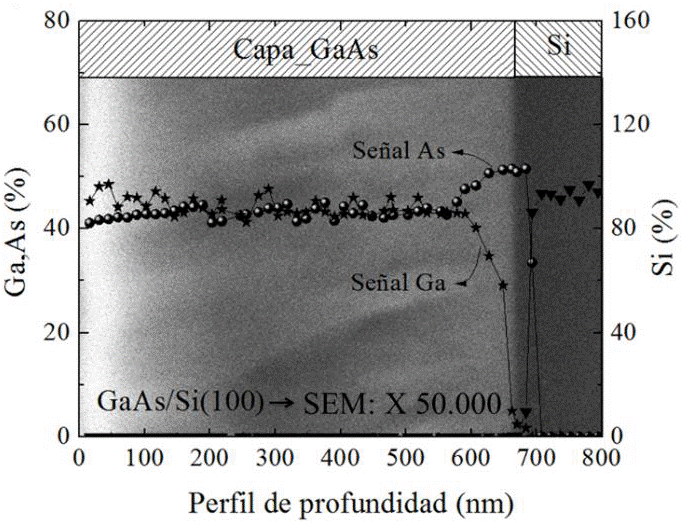
Figura 4 Perfil de profundidad obtenido por espectroscopia de masa de iones secundarios (SIMS) sobre la capa de GaAs/Si(100). La imagen SEM de fondo muestra un espesor estimado de la capa de GaAs es de 680 nm.
La Figura 5 muestra los espectros realizados sobre la capa de GaAs/Si(100). En el espectro se observan picos asociados al Ga3d y As3d, además de picos asociados al C1s y O1s, debidos a contaminación por la exposición de la muestra con el medio después del proceso de preparación de la muestra. La corrección de los espectros se realizó tomando como referencia el valor de energía de enlace del C-C 384.4 eV. Otros picos fueron atribuidos a señales Auger, tal como se indica en las gráficas.
Un espectro tomado en la región angosta característica de Ga3d y As3d, permitió realizar una discretización y discusión de los resultados sobre el comportamiento de la superficie de la muestra después de ser expuesta al ambiente. El análisis se hizo teniendo en cuenta que los óxidos estables de GaAs son: As2O3, As2O5, Ga2O3, Ga2O, GaAsO4. Este resultado junto con una comparación de los estados de Metal2O3, permite concluir que los óxidos de As son más inestables que lo óxidos de Ga. Por otro lado, se sabe que los óxidos nativos de arseniuro de galio son principalmente As5+, As3+, Ga3+ y Ga1+, de acuerdo a lo reportado en la literatura [15].
Los espectros de la región característica del Ga se tomaron en la región entre 14 y 24 eV (Figura 6 (a)). En cada uno de ellos, se ve la línea experimental, además del ajuste realizado, lo cual permitió identificar los estados de hibridación del Ga. Las energías de enlace en 18.45 eV y 18.46 eV corresponden al estado Ga3d, valor que está de acuerdo con lo reportado para el arseniuro de galio [16]. El GaO presente en ambas muestras es atribuido a contaminación superficial posterior al proceso de preparación de la muestra. Su aparición en los espectros se debe a que XPS es una técnica de análisis estrictamente superficial, donde la longitud de penetración máxima es del orden de los 9 nm. Este fenómeno de oxidación en la superficie fue corroborado en los resultados SIMS y Raman, debido a que en SIMS la señal de oxígeno aparece hasta una región no mayor a 50 nm y en Raman no se observó GaO al aumentar la longitud de penetración utilizando líneas láser de mayor longitud de onda (no mostrados aquí).
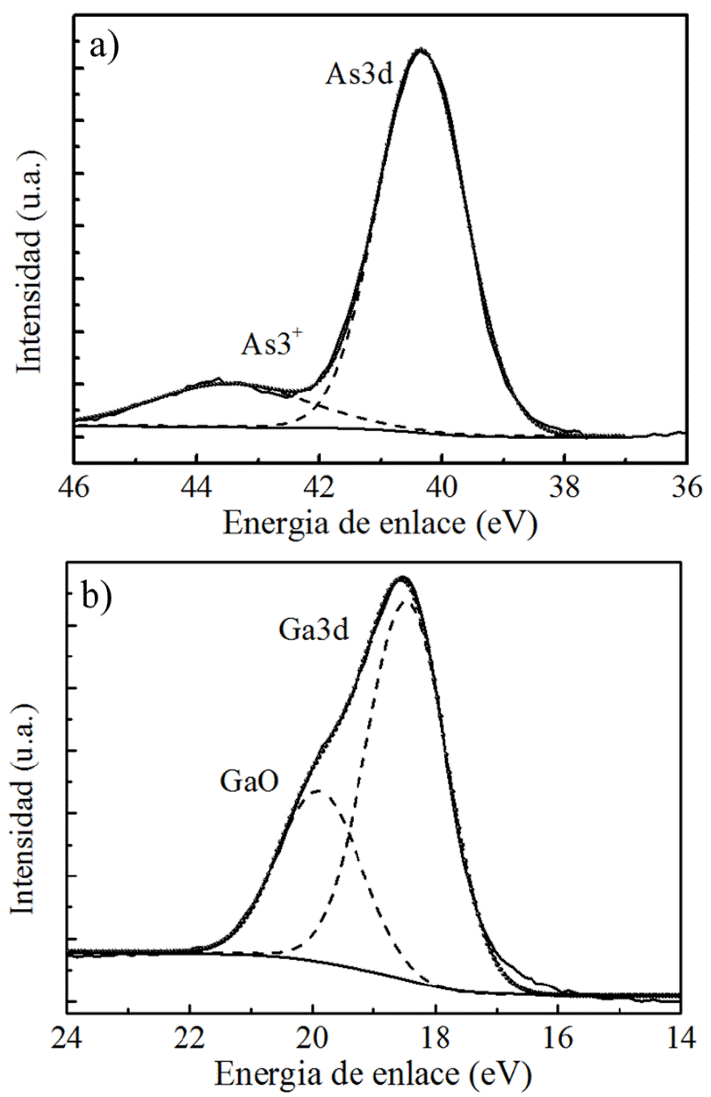
Figura 6 Espectros XPS en regiones características de Ga3d 14 - 24 eV (a) y As3d 36 - 48 eV (b) para la capa de GaAs depositada sobre Si.
En los espectros de As tomados en la región 36 - 48 eV (Figura 6 (b)) se realizó un tratamiento matemático similar que para el Ga, en estos espectros, la posición del As3d (V0: 40.29 eV y S0: 40.33 eV) está de acuerdo con lo reportado para el GaAs, pero también aparecen estados de hibridación con el oxígeno As3+. Lo anterior es congruente con los resultados de SIMS de la sección anterior, en donde se han reportado óxidos tanto para el Ga como para el As a pesar de que los óxidos de As son más inestables y menos frecuentes a altas temperaturas de preparación.
Con el fin de estimar el valor del ancho de banda prohibido (Eg) del semiconductor, se realizaron medidas de espectroscopia fotoacústica a temperatura ambiente (PAS) en la capa de arseniuro de galio depositada sobre un sustrato de Si(100). Lo anterior debido a que el sustrato es opaco en el visible, y no es posible determinar el ancho de banda por absorción óptica. La Figura 7 muestra el espectro de la intensidad de la señal fotoacústica en función de la energía de excitación. En la primera región marcada (I) en la gráfica, se observa como decrece la señal fotoacústica con el aumento de la energía de excitación, hasta alcanzar el mínimo justo en el borde de absorción del arseniuro de galio. Este criterio fue utilizado para determinar el ancho de banda del semiconductor encontrando un valor de Eg = 1.43 eV. El mínimo en la señal fotoacústica es característico de una transición entre procesos de recombinación en volumen y de recombinación superficial.
El borde de absorción del GaAs se indica en la región (II) con línea punteada. El recuadro de la figura 7 ilustra un ajuste usando la ecuación (1) para un semiconductor de ancho de banda directo,
Donde Γ es un parámetro de ajuste y λ0 es una constante introducida con el fin de corregir el posible error en los datos [17]. El valor del ancho de banda obtenido mediante la ecuación (1) fue Eg = 1.435 eV, que está en buen acuerdo con lo reportado para este semiconductor a temperatura ambiente [18]. Los picos observados por arriba del borde de absorción pueden ser atribuidos a excitones libres y demás fenómenos de absorción de GaAs.
Capa de GaAsMn depositada sobre Si (100)
La Figura 8 (a) se muestra la imagen de microscopía de fuerza atómica (MFA) tomada en una área de 5 × 5 μm2, donde se observan una superficie muy homogénea con una rugosidad promedio (RMS) de 42 Å. En esta escala no se observa la formación de poros, la cual es corroborada mediante la imagen SEM que se muestra en la Figura 8 (b), tomada con una magnificación de 5000× en una escala de 1 μm La distribución granular calculada a partir de AFM se muestra en el inserto de la Figura 8 (b), donde los granos tienen una altura promedio de 10 nm.

Figura 8 (a) Imagen de MFA tomada en una escala de 5 × 5 μm2 . b) Imagen SEM tomada en un área de 1 × 1 μm2 . En el inset de la Figura b) se muestra la distribución de altura.
Con el fin de determinar la estructura cristalina de la muestra de GaAsMn se presenta un difractograma de rayos X en el rango de 20 hasta 80 grados, como se muestra en la Figura 9. En este difractograma se identifica el plano principal de reflexión del substrato de Si (100) localizado en 2θ = 68.5 °. En el background del difractograma se identifica el plano (002) muy bien definido correspondiente a GaAs localizado en 2θ = 26 °, indicando que la muestra tiene una orientación preferencial en esta dirección. Además, se identifica las reflexiones en 2θ = 43.4 °, 52.8 ° y 60.1 °, correspondientes a fase tetragonal de MnAs debido posiblemente a la segregación de Mn, ó a la formación de agregados (clusters) típicos en esta aleación, debido al alto contenido de Mn (16 %). Es de anotar que MnAs presenta una estructura hexagonal tipo niquelina (NiAs) con parámetro de red a = 3.7187 Å y c = 5.7024 Å, y presenta ferromagnetismo a temperatura ambiente [19]. Todos los planos presentan un corrimiento hacia ángulos mayores respecto a la posición del plano (002) de GaAs en bulto, a excepción el plano del substrato (004), lo cual es un indicativo que se debe a efectos combinados de aleación por el alto contenido de Mn y esfuerzos biaxiales de estiramiento generados durante el crecimiento por la diferencia del parámetro de red del substrato y de la capa de GaAsMn. Estos esfuerzos de estiramiento se deben a la creación de defectos anti-sitios MnAs, ocupación de átomos de Mn en los sitios de Ga, Mn intersticial en la red de GaAs por la formación de estructuras granulares como lo muestran las imágenes de MFA.

Figura 9 Difractograma de rayos X de la muestra de GaAsMn. El plano de mayor intensidad corresponde al substrato de Si (100). Los planos etiquetados con (+) y (*) corresponde a la fase de GaAs y MnAs.
La Figura 10 muestra los espectros Raman tomados a temperatura ambiente en una configuración de retrodispersión z(x,x) 𝑧̅, para las capas de GaAs (tomado como referencia) y GaAsMn. Con el fin de evitar al máximo la dispersión Raman del sustrato, se utilizó la línea de 632.8 nm de un láser He-Ne con una potencia de 20 mW, como fuente de excitación. En la Figura 10 se muestra el espectro Raman de un cristal de GaAs (001) (tomado como referencia) donde se identifican los modos vibracionales TO y LO en 290 y 265 cm-1, respectivamente. Para la capa de GaAsMn, adicional a los modos vibracionales de GaAs, se se observa la aparición de un modo fonónico LO de plasmones acoplados (CLOPM: coupled LO plasmon mode) entre los modos TO y LO de GaAs, debido a un desorden de la red por defectos internos inducidos cuando una alta concentración de Mn (> 7 %) se incorpora en la matriz de GaAs [20]. Los modos TO y LO del ternario presentan un corrimiento de 5 cm-1 hacia valores menores de k, respecto a los valores del cristal GaAs, debido a esfuerzos internos generados durante el crecimiento de las capas. Se observa además, que la intensidad del modo LO de la capa de GaAsMn disminuye drásticamente, mientras que la intensidad del modo TO aumenta por la incorporación de átomos de Mn en la matriz de GaAs característico de un desorden estructural. Por otro lado, se observaron dos modos longitudinales acústicos (DALA L y DALA X) activados por defectos en 199 cm-1 y 226 cm-1. Resultados similares se han reportado en muestras de GaAs por la implantación de iones de Mn en un cristal de GaAs [21].
Las medidas de SIMS se realizaron en perfil de profundidad (desde la superficie hacia el interior y en dirección hacia el substrato) sobre la muestra de GaAsMn como se muestra en la Figura 11. En el espectro se evidencia la existencia de Ga, As y Mn. Es importante resaltar que la concentración de Ga y As a lo largo de la muestra es uniforme, lo cual indica que la muestra es homogénea. De otro lado, se observa que la cantidad de Mn tiende a aumentar en la superficie y disminuye considerablemente al interior de ella. Este efecto se debe probablemente a la desorción de átomos de Ga durante los últimos instantes de preparación de la muestra, y aun aumento en los átomos de Mn que los reemplazan.
Para analizar el comportamiento magnético de la capa GaAsMn/Si se realizaron medidas de magnetización en función de la temperatura, usando los procesos de enfriamiento a campo magnético nulo, ZFC, y enfriamiento con magnético campo aplicado, FC. Para tal efecto se aplicó un campo magnético externo de 250 Oe paralelo a la superficie de la muestra. Los resultados son ilustrados en la Figura 12. La curva de magnetización ZFC a bajas temperaturas presenta un máximo alrededor de 98 K. Además, se observa una pequeña irreversibilidad cuando se comparan los resultados de magnetización obtenidos en los procesos ZCF y FC. Esta irreversibilidad inicia aproximadamente un poco por encima de la anterior temperatura. Posteriormente la curva ZFC decrece y alrededor de la temperatura 130 K presenta una débil estructura de un mínimo, para finalmente decrecer a medida que la temperatura aumenta presentando un típico comportamiento paramagnético. El magnetismo en las capas de GaAsMn probablemente se debe a la formación de cluster de MnxAsy, el cual da como consecuencia un cambio estructural orden - desorden de la matriz de GaAs por incorporación de átomos de Mn. El aumento en la magnetización por debajo de 40 K se debe posiblemente a un atrapamiento de los portadores de espines polarizados, debido a fuertes campos de dispersión de clusters de MnAs ferromagnéticos [7].
Conclusiones
Se prepararon capas de GaAs y GaAsMn por pulverización catódica asistida por campo magnético. La capa de GaAs es policristalina con orientación preferencial (111) consistente con las reglas de selección Raman. Las propiedades estructurales de la capa de GaAsMn muestran la formación de una fase de MnAs. Los resultados SIMS de la capa de GaAsMn muestran una composición que es homogénea en todo su espesor. Las medidas de magnetización como función de la temperatura para ZFC y FC muestran que ésta presenta un comportamiento paramagnético posiblemente debido a la formación de una fase de MnAs. Finalmente, se conluye que MS es una alternativa para la obtención de semiconductores III-V y III-V:Mn policristalinos en forma de capa delgada.











 nueva página del texto (beta)
nueva página del texto (beta)