1. Introducción
Los materiales semiconductores del grupo III-V han sido ampliamente utilizados y estudiados para el desarrollo de dispositivos electroópticos como diodos emisores de luz (LED’s) y láseres [1-4], que de manera convencional se fabrican mediante la deposición de películas semiconductoras delgadas por técnicas como epitaxia por haces moleculares (MBE) o por epitaxia metalorgánica en fase de vapor (MOCVD) [5-7]. Las investigaciones dirigidas al desarrollo e innovación de las tecnologías para las telecomunicaciones demandan una mejora continua y son de considerable importancia, en particular en lo que se refiere a los procesos de transmisión y recepción de datos. Varias líneas de investigación continúan en la dirección de los dispositivos pasivos de los sistemas de telecomunicaciones, como por ejemplo en la reducción de la absorción por medio de dopajes en las fibras ópticas, así como el aumento en la calidad de estas líneas de transmisión, pero la mayor parte de los esfuerzos se centran en el desarrollo de los dispositivos ópticos emisores de luz con las características propias de los laseres.
Para la fabricación de láseres de confinamiento separado es necesario depositar una sección cuya función es mantener confinada la luz en una cavidad reflectora y otra sección en la que los electrones experimenten un confinamiento debido a la presencia de una barrera de potencial que se genera al depositar una capa de un semiconductor con una banda de energía prohibida lo suficientemente mayor para que el efecto de confinamiento de portadores sea efectivo [8]. Para lograr obtener un láser cuya emisión de la zona activa esté centrada en la ventanas de menor absorción para telecomunicaciones por fibra óptica (1.3 y 1.55 µm) [9,10], es necesario recurrir a defectos controlados que conforman sistemas de confinamiento electrónico como pozos o puntos, cuya geometría deriva en propiedades cuánticas que permiten obtener dispositivos con características ópticas apropiadas para este fin.
El espectro de emisión mejora ampliamente cuando los electrones son confinados en dos dimensiones por medio de pozos cuánticos, sin embargo, el semiancho de la forma de línea del espectro energético de la emisión disminuye si esté se confina en tres dimensiones al insertar puntos cuánticos auto-ensamblados de manera que la eficiencia del dispositivo aumenta considerablemente al mismo tiempo que disminuye la temperatura de trabajo y la corriente de umbral [11,12]. La fabricación de estas heteroestructuras es complicada debido a la dinámica de difusión del Indio que provoca gradientes de composición en el material ternario de InGaAs durante el crecimiento inducidos por la energía térmica adquirida inherentemente en el proceso. Lo que produce defectos interfaciales y, por lo tanto, pequeñas deformaciones en las fronteras de la estructura cuántica cuya respuesta implica diferente soluciona la ecuación de onda produciendo cambios en los subniveles calculados de las bandas de conducción y de valencia.
En la presente comunicación se reporta la fabricación y caracterización de láseres de puntos cuánticos (LPCs) crecidos por MBE con una longitud de onda de emisión en 1019 nm. A partir de estos resultados se corrobora la capacidad de fabricación de láseres cuyas emisiones se centren en longitudes de onda del rango de interés para aplicaciones como telecomunicaciones por fibras ópticas, detectores de contaminantes, entre otras.
2. Fabricación del dispositivo
La heteroestructura laser consiste en la deposición epitaxial de películas semiconductoras por medio de una cámara de MBE sobre un sustrato cristalino epi-ready de GaAs (001) tipo-n con un dopaje nominal de 1×1018 cm−3. Los materiales utilizados en la cámara de crecimiento son In, Ga y Al como cationes y el As como anion. En éste último se utilizó una celda tipo Cracker para garantizar la dimerización de las moléculas de Arsénico y para controlar el flujo molecular en diferentes momentos del crecimiento dependiendo de las características de la capa depositada. Además, se utilizaron los elementos Si y Be como dopantes tipo-n y tipo-p, respectivamente, para generar la heterounion del diodo semiconductor.
El confinamiento óptico se obtiene depositando 1 µm de Al0.35Ga0.65As dopado que funciona como una barrera óptica dado el contraste en términos del índice de refracción con las capas emparedadas. Estas películas funcionan también como emisores de los portadores tipo-n (electrones) y de tipo-p (huecos) que se recombinaran en el área activa. El espesor utilizado fue determinado en función de la longitud de onda de emisión que se pretende obtener (alrededor de 1 µm), es decir, que la onda electromagnetica producida pueda mantenerse confinada en la cavidad resonante. El confinamiento electrónico se logra obtener depositando un emparedamiento de 0.25 µm de GaAs. La energía de banda prohibida de este binario permite que los portadores estén sometidos a un confinamiento electrónico y con esto se obtiene una mayor probabilidad de que estos participen en la recombinación dentro del área activa. En la Fig. 1 se muestra el esquema de la de posición de material (espesor) respecto a la energía de banda prohibida de cada capa de la estructura laser en donde la zona activa está conformada por la deposición de pozos cuánticos en los que se insertaron puntos cuánticos autoensamblados, ésta secuencia se repitió tres veces y conforma la matriz del área activa del láser.
En la Tabla I se detallan las condiciones de crecimiento de las películas en la cámara de deposición en función del espesor, la composición (x), el dopaje, la velocidad (V dep ), la temperatura de crecimiento (T crec ) y la presión del flujo molecular de los materiales binarios y ternarios de la estructura laser de puntos cuánticos. El orden descendiente en la tabla corresponde a la dirección de crecimiento de las películas incluyendo al sustrato.
TABLA I Condiciones del sistema MBE durante el crecimiento de la estructura laser.
| Material | Función de la capa |
Espsor (nm) |
x | Dopaje (1018cm-3) |
Vdep (ml/s) |
Tcrec (oC) |
Flujo molecular (10-9Torrs) |
| GaAs-n+ | Sustrato | 150,000 | - | Si=1 | - | - | - |
| GaAs-n+ | Buffer | 100 | - | Si=1 | 1.00 | 600 |
P
Ga= 140 P As= 5500 |
| Al x Ga1-xAs-n+ | Emisor tipo-n | 1,000 | 0.35 | Si=1 | 0.75 | 630 |
P
Al= 47 P Ga= 140 P As= 5500 |
| GaAs | Guía de onda | 250 | - | - | 1.00 | 600 |
PGa= 140 P As = 5500 |
| In x Ga1-xAs | Pozo cuántico | 2 | 0.15 | - | 0.28 | 480 |
P
In= 31 P Ga= 60 P As= 2000 |
| InAs | Puntos cuánticos | 4 | - | - | 0.04 | 480 |
P
In= 31 P As= 2000 |
| InxGa1-xAs-p+ | Pozo cuántico | 8 | 0.15 | - | 0.28 | 480 |
P
In= 31 P Ga= 60 P As= 2000 |
| GaAS | Guía de onda | 250 | - | - | 1.00 | 600 |
P
Ga= 140 P As= 5500 |
| AlxGa1-xAs-p+ | Emisor tipo-p | 1,000 | 0.35 | Be=4 | 0.75 | 630 |
P
Al= 47 P Ga= 140 P As= 5500 |
| GaAs-p+ | Cubierta | 100 | - | Be=30 | 1.00 | 600 |
PGa= 140 P As= 5500 |
El área activa del LPC está basada en In x Ga 1−x As y consiste en la deposición de una matriz de tres repeticiones de pozos cuánticos de In0.15Ga0.85As, en los cuales se incrustan los PCs de InAs [13]. La emisión de la luz láser depende del tamaño de los PC y varía dentro del rango de las ventanas de menor absorción de las fibras ópticas [14,15]. Aunque las dimensiones de un PC son a escala nanométrica, como sé muestra en la imagen tomada por microscopia de tunelamiento en la Fig. 2, es posible controlar el promedio dimensional y la densidad de ellos con base en las condiciones de crecimiento y proporción de los elementos constitutivos de las diversas películas dentro de la cámara de deposición que componen la estructura, de tal manera que se favorece los puntos cuánticos auto-ensamblados con las características deseadas. Para el dispositivo sintetizado, la densidad estimada de PCs a través de la microscopia de tunelamiento es del orden de 3.05×1011 PC/cm2.

FIGURA 2 Imagen de puntos cuánticos tomada por microscopia de tunelamiento in-situ. En esta figura es observable 11 puntos cuánticos con una altura de 4 nm y sección transversal de 75 nm2 en promedio, sobre una región de 3,600 nm2.
La fabricación del chip láser incluye un proceso fotolitográfico post-crecimiento en el cual la estructura se somete aún proceso de pulido para dejar un espesor de hasta 100 µm del lado del sustrato. En la superficie se deposita SiO2 como dieléctrico y una resina fotosensible y sobré estas se coloca una mascarilla con motivos alineados en la dirección [110] del cristal. La muestra es expuesta a luz ultravioleta con el fin de revelar a la resina, mientras que el dieléctrico queda expuesto y es atacado químicamente creando surcos en la superficie de la estructura que servirán para canalizar la inyección de corriente; por último, la resina restante es removida con solventes. El proceso final en la fabricación consiste en la deposición de metales como contactos óhmicos sobre los surcos anteriormente descritos, en este caso Oro, y para la parte inferior o del sustrato, se depositan Oro y Germanio. Los contactos son horneados a fin de garantizar una aleación metal semiconductor del tipo óhmico que permita obtener una baja resistividad del dispositivo. En la Fig. 3a se puede apreciar el tamaño físico del láser con dimensiones de 500 µm de largo por 100 µm de sección transversal y una altura o espesor de 100 µm, en comparación con el tamaño de un cabello humano y el de un fosforo común, la imagen fue tomada en un´ microscopio óptico convencional. En la Fig. 3b se muestra un esquema de la estructura del láser que se reporta.
3. Resultados experimentales
La caracterización del espectro de emisión del láser fue obtenida por medio de electroluminiscencia y es mostrada en la Fig. 4. El láser estudiado mostró una emisión centrada en una longitud de onda (λ) de 1019 nm (1.216 eV) con un semi-ancho de 2.3 meV a temperatura ambiente. La inyección de corriente se aplicó por medio de una fuente de alimentación en régimen pulsado con un ciclo de trabajo (PWM I ) del 7.8% (10 µs /128 µs) y una corriente pico de 4 A.
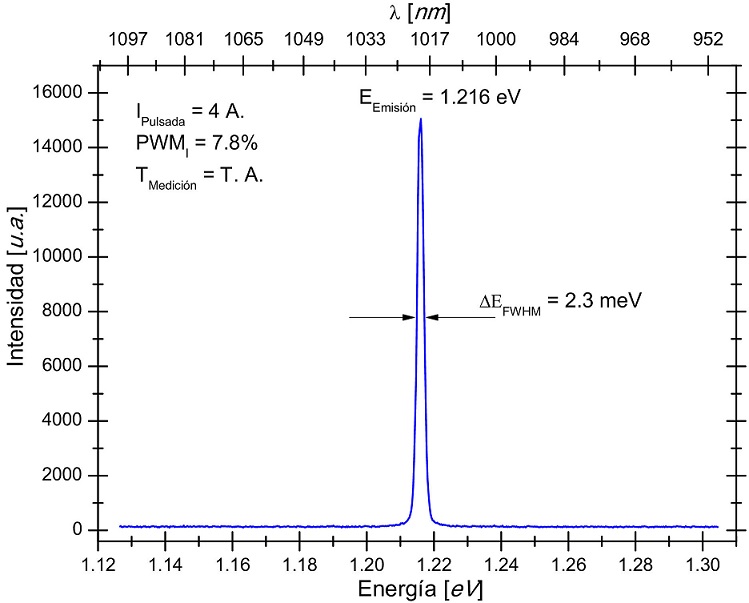
FIGURA 4 Espectro de electroluminiscencia del dispositivo laser de puntos cuánticos medido a temperatura ambiente y sometido a corriente pulsada. La ausencia de emisiones satélite alrededor de la emisión principal y su delgado ancho espectral de emisión denota la alta calidad del dispositivo.
La curva característica de Corriente-Voltaje (C-V) del láser mostrado en la Fig. 5 indican una baja resistencia serie de 1.5 Ohms. Este valor de resistencia es importante para limitar el calentamiento del láser durante su operación causado por el inherente efecto Joule en este tipo de dispositivos donde la corriente eléctrica es suficiente para lograr un calentamiento considerable a pesar de las dimensiones microscópicas del dispositivo y el régimen de corriente pulsada que se inyecta al laser para evitar los efectos de degradación. Con la curva podemos conocer la intersección de la recta ajustada a la pendiente, en la sección de respuesta lineal, con el eje horizontal. El valor del cruce representa el voltaje de umbral a partir del cual el diodo semiconductor es capaz de conducir corriente.
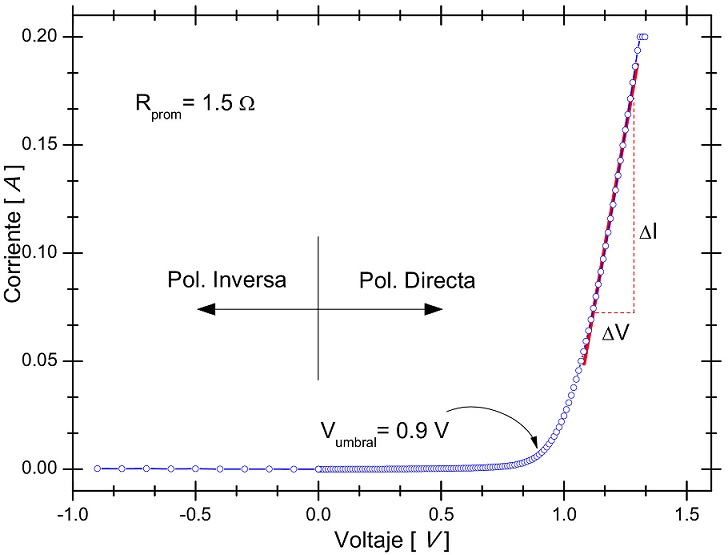
FIGURA 5 Caracterización eléctrica por Corriente-Voltaje. En rojo se resalta el ajuste lineal sobre el régimen óhmico del desempeño del dispositivo en polarización directa. De la pendiente de la recta, determinada mediante un ajuste por mínimos cuadrados en este régimen, se deduce la resistencia promedio del dispositivo.
En la Fig. 6 se muestra la curva característica de Corriente-Potencia (C-P) del láser. La caracterización eléctrica por C-P nos permitió conocer que la responsividad (R) para el dispositivo que se fabrico es del 95.4 mW/A, obtenida a´ partir de la expresión
en donde ∆P es el cambio en la potencia óptica emitida, mientras que ∆I es el cambio de la corriente inyectada en el régimen de respuesta lineal. Para el cálculo se consideró que la fuente de alimentación proporcionaba un PWMI de 2 µs/128 µs con el cual se inyectaba la corriente al dispositivo en régimen pulsado y a temperatura ambiente.
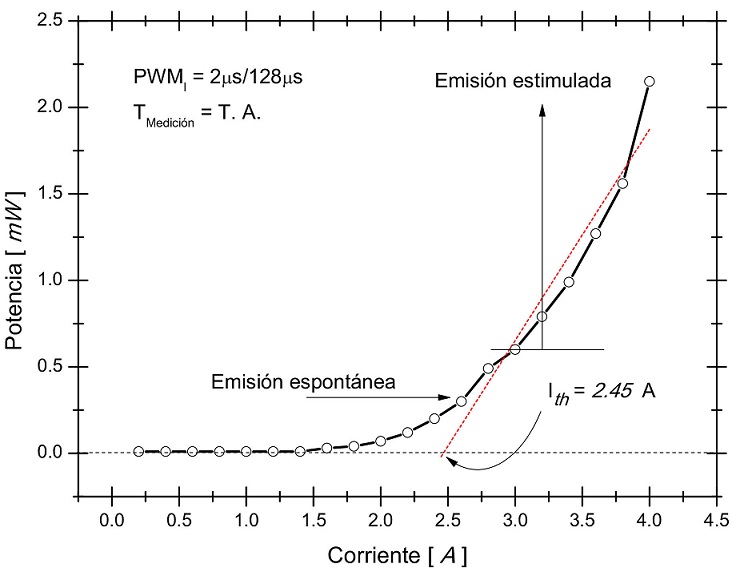
FIGURA 6 Potencia de salida del diodo laser en función de la corriente de entrada. Se considera al régimen de estimulación espontanea para determinar la corriente de umbral bajo un ajuste lineal.
Se observan claramente los rangos de emisión espontánea y estimulada de radiación en la Fig. 6. Con esta última se extrae la pendiente que indica el punto de corte a la gráfica con él eje de la corriente correspondiendo un umbral (I th ) de 2.6 Amperios.
En la literatura se han reportado corrientes de umbral del orden de miliamperes [16] que, comparado con el presente trabajo, representa una pequeña porción de corriente, sin embargo, esto refleja la capacidad tecnológica de clivado del dispositivo ya que también se debe tomar en cuenta su tamaño debido a que entre más grande sea el área de contacto, mayor corriente se necesita para obtener la luminiscencia. Para evitar esta ambigüedad, el parámetro de referencia tecnológica de caracterización es la densidad de corriente, ya que esta contempla el área de contacto antes mencionada. Para aumentar el rendimiento del láser es necesario disminuir ésta corriente de umbral para evitar el calentamiento y transmitir más energía al proceso de radiación láser. Considerando las dimensiones del chip laser, se obtiene una densidad dé corriente en el umbral (J th ) de 5,200 A/cm2 a partir de
en donde la escala del dispositivo dimensiona la energía suministrada. En este caso el contacto de tira del chip tiene un ancho (d) de 0.01 cm y un largo (L) de 0.05 cm, lo cual corresponde a un área de 0.0005 cm2. La densidad corriente de umbral es muy alta comparada con la literatura contemporánea [17], esto se debe esencialmente a la calidad de los´ contactos óhmicos.
Finalmente, en la Fig. 7 se muestra la potencia óptica emitida por el láser a temperatura ambiente y la cual está en función del ciclo de trabajo de la corriente suministrada. Se obtuvieron potencias pico de 123 mW por faceta, lo cual indica que la potencia total del dispositivo laser fue de 246 mW. Estos valores se obtuvieron a partir de la exploración de varios dispositivos clivados de la misma muestra, por lo que el promedio de estos láseres indica una consistencia y una reproducibilidad tanto en las condiciones de crecimiento como en el post-procesado del dispositivo.

FIGURA 7 Caracterización eléctrica de la potencia emitida respecto al ciclo de trabajo de la fuente pulsada para la inyección de corriente. Se señala en línea no continua la extrapolación de la curva que permite conocer la potencia pico por faceta bajo corriente continua. En el recuadro se observa el detalle de los datos experimentales empleados para la estimación de la potencia del dispositivo trabajando en el régimen de modo continuo.
4. Conclusiones
En este artículo se presenta la fabricación de láseres de puntos cuánticos de InAs insertados en una matriz de tipo pozo cuántico de InGaAs y cuya formación obedece a un mecanismo de auto-ensamble. La caracterización eléctrica por C-V índica que las condiciones de fabricación de los contactos eléctricos son correctas dado que el valor de la resistencia obtenida es bajo. En cuanto los resultados de potencia óptica de emisión del LPC, se obtuvo que en un régimen pulsado el láser emite una potencia óptica total de 246 mW, valor qué sostuvo el dispositivo durante horas sin quemarse o degradarse. La densidad de corriente de umbral es alta comparada con los dispositivos reportados actualmente en la literatura y resulta absolutamente necesario mejorarla para disminuir los efectos de calentamiento, esto representa para el grupo de investigación un nicho de oportunidad alcanzable. Las características de los PCs, en cuanto a su tamaño y a su densidad, permitieron la obtención de una emisión láser en 1019 nm con lo que se proyecta que en un futuro próximo se puedan elaborar LPCs capaces de ser fabricados en los rangos de interés, específicamente en las ventanas de menor absorción para aplicaciones relacionadas con la transmisión en telecomunicaciones por fibra óptica o para la detección de contaminantes en el cercano infrarrojo.











 nueva página del texto (beta)
nueva página del texto (beta)