PACS: 61.05.CC; 61.72.-y; 61.72.Dd; 61.72.Ff
1. Introducción
Los semiconductores ternarios proveen un modo natural de ajustar y modular la brecha de energía en el rango deseado y controlar las propiedades físico-químicas del variando la composición relativa de los elementos puros en el compuesto. Un grupo especial de ternarios es aquel basado en los elementos de los grupos I-III-VI, tal como (Ag, In)(S, Te, Se), CuInSe2 y AgGaTe21,2,3. Estos compuestos cristalizan en el sistema no-centro simétrico de la calcopirita con vacancias electrónicas en el sitio catiónico respecto del sitio del anión, y son también denominados “Compuestos de Vacancias Ordenadas (CVO)”. Esta propiedad confiere a los semiconductores ternarios del tipo I-III-VI, características promisorias para aplicaciones en dispositivos opto-electrónicos, células solares, células foto-electroquímicas, entre otras aplicaciones 4.
En un estudio reciente, centramos nuestro interés en el efecto del ión del grupo VI sobre las propiedades estructurales y térmicas en compuestos ternarios AgIn5VI85. Estos son semiconductores de la familia I-III-VI que cristalizan en la estructura tetragonal u ortorrómbica dependiendo del elemento del grupo III. Son materiales de gran importancia para aplicaciones tecnológicas ya que su brecha óptica está cerca del valor óptimo para reconversión de energía solar, también poseen propiedades termoeléctricas útiles para la industria automotriz, aires acondicionados y refrigeración, etc. 6. A parte de esto, estos sistemas ternarios son la base para el diseño de nuevos y más complejos materiales, en especial los semiconductores cuaternarios 7.
Las propiedades estructurales y térmicas de un sólido semiconductor están íntimamente ligadas a su microestructura, y comprender ésta relación es sumamente importante para muchos procesos industriales. Más aún, las propiedades físicas de los elementos semiconductores que conforman un microdispositivo dependen enormemente de los parámetros microestructurales, tales como, el grado de cristalinidad, orientación cristalográfica, tamaño de grano ó cristalito, deformación elástica/plástica, dislocaciones y defectos, etc. Entre las técnicas empleadas para determinar los parámetros microestructurales en sólidos policristalinos, la difracción de rayos X (DRX) juega un papel de gran importancia en la Ciencia de Nuevos Materiales. Esto es porque los patrones de DRX son muy sensibles a la estructura y orientación cristalográfica, cambios de fase, defectos estructurales, composición química, etc., que son esenciales en la interpretación de datos de deformación/estrés.
Debido a sus potencialidades tecnológicas, la caracterización de las propiedades de los compuestos ternarios AgIn5VI8 ha tenido gran importancia entre la comunidad técno-científica en la Ciencia de Nuevos Materiales. El propósito fundamental de éste trabajo es estudiar la microestructura del sistema In5VI8 (VI=S, Se, Te). Para esto, empleamos el análisis de tensión/tamaño por DRX sobre muestras policristalinas sintetizadas mediante la fusión directa de la mezcla estequiométrica de los elementos constituyentes. Este artículo es organizado de la siguiente manera. En la Sec. 2 describimos brevemente los métodos experimentales. La Sec. 3 es dedicada a las bases teóricas necesarias para un análisis de deformación/tamaño basado en patrones de DRX. En la Sec. 4 mostramos los resultados y su discusión, y en la Sec. 5 las conclusiones más relevantes.
2. Métodos experimentales
Para la obtención de los compuestos se seleccionó la técnica de síntesis directa a partir de la mezcla estequiométrica de los elementos constituyentes. Para esto, los elementos pesados en cantidades estequiométricas se introdujeron en cápsulas de cuarzo grafitadas por pirólisis con acetona, las cuales fueron posteriormente selladas a ∼10-6 torr. Para la fusión se utilizaron hornos verticales y un programa de crecimiento o síntesis controlado automáticamente. Manteniendo un volumen libre en las cápsulas lo suficientemente grande se previene que las presiones de vapor sean un inconveniente. Por otro lado, aumentando lentamente la temperatura desde algunos grados por debajo del punto de fusión de los elementos del grupo VI, se controlan las posibles reacciones exotérmicas de éstos con los elementos del grupo III. Los compuestos fueron crecidos en el Laboratorio de Ciencia de Materiales del Departamento de Física, Facultad Experimental de Ciencias, Universidad del Zulia.
La difracción de rayos X en polvo se llevó a cabo en el Centro Nacional de Difracción de Rayos-X de la Universidad de Los Andes, utilizando un equipo Siemens D5000 con ánodo de cobre (λ = 1,5406 Å) y geometría Bragg-Brentano. Se midió en el intervalo de 2θ entre 5° y 100° con un paso de 0.02°, mientras que el tiempo de toma de medidas fue de 15.0 s/paso. Para procesar el difractograma se utilizó el sistema de interfaz gráfico de Winplotr, que incluye el programa Treor 90 para la indexación de las líneas de difracción. Los parámetros micro-estructurales fueron obtenidos a partir del ancho de línea a media altura ó FWHM (en sus siglas en inglés) de las líneas de difracción, empleando un análisis de tensión/tamaño basado en las ecuaciones modificadas de Scherrer 8.
3. Análisis microestructural
El análisis microestructural por DRX de un material sólido se basa fundamentalmente en el cálculo de parámetros microestructurales tales como tamaño de cristalito/grano, las fuerzas de tensión elástica y dislocaciones cristalinas. El tamaño de grano/cristalito es usualmente relacionado con el perfil de DRX a través del ancho a media altura (FWHM por sus siglas en inglés) de la línea de difracción hkl, mediante la bien conocida fórmula de Scherrer 9,
donde βhkl es el ancho del pico de difracción correspondiente a la dirección (hkl) en radianes, K=2[ln(2)/π]1/2 ≅ 0.93 es una constante relacionada con la forma del grano/cristalito, λ y L la longitud de onda del haz de RX y el tamaño medio del grano/cristalito, en Å, respectivamente, y θ el ángulo de Bragg en grados. La ecuación de Scherrer es el caso limite en el que sólo consideramos el tamaño de grano de los cristalitos como responsable del ensanchamiento de los picos de difracción, y sólo predice valores de L cercanos a los obtenidos mediante microscopia electrónica de barrido cuando el cristalito y el grano son similares, tal como en el caso de un material nanoestructurado. Desafortunadamente, la presunción de que el cristalito y el grano son similares no es generalmente válida en un policristal, en el cual las escalas de tamaño se miden en micras. En general, la estructura de un sólido policristalino está determinada por granos compuestos por muchos cristalitos orientados en diferentes direcciones, y estos últimos se constituyen de varias celdas unitarias. En estos casos, los efectos de tamaño pueden ser enmascarados por una microestructura anisotrópica, caracterizada por la presencia de micro tensiones entre los planos atómicos. Ya que las microtensiones tienen su origen en las fuerzas de compresión elásticas, estas deben ser compensadas por fuerzas plásticas generando en consecuencia dislocaciones y deformaciones a lo largo de todas las orientaciones cristalinas, fallas de apilamiento, vacancias, gradientes de composición, etc. Debido a este proceso de relajación, las líneas del perfil de difracción muestran un ensanchamiento adicional, dado por la expresión 10
donde ε = (d'-d)/d es la microtensión media entre los planos cristalinos (hkl) y es una medida de la deformación elástica en el matrerial; d y d' son las distancias interplanares sin deformación y después de la deformación, respectivamente.
Otro aspecto a considerar en el análisis son las aberraciones introducidas por el instrumento al FWHM, βinst. El ensanchamiento instrumental es obtenido empíricamente de un espectro de referencia de silicio, a partir de la fórmula de Caglioti 11
donde U, V, W son parámetros de ajuste de la línea de difracción de base. En nuestro caso, U = 0.000010, V = 0.0000015 y W = 0.0000055. Con esto, el ancho de línea a media altura, βFWHM, se relaciona con la microestructura del material mediante la suma directa de cada contribución
La Ec. (4) es empleada cuando el perfil de la línea de difracción es del tipo Lorentziano. Estos perfiles se observan típicamente cuando el campo de micro-deformaciones es isotrópico y los efectos de tamaño predominan sobre la distribución de microtensiones. Sin embargo en el caso de materiales policristalinos anisotrópicos, el campo de tensiones es anisotrópico y contribuye a la línea de difracción con un perfil Gaussiano, con ancho de línea a media altura determinado por la expresión cuadrática,
Las Ecs. (4) y (5) son conocidas como ecuaciones modificadas de Scherrer, y son la base fundamental del análisis de tensión/tamaño ó microestructural en materiales sólidos. En ciertos materiales, donde la cristalinidad es muy baja, el perfil del espectro de DRX corresponde a una combinación lineal de una función Lorentziana y una Gaussiana, con lo cual el análisis se torna más complicado. Los parámetros microestructurales, L y ε, se determinan mediante un ajuste del ancho de línea experimental, βFWHM, con la función (4) ó (5), según sea el caso. Como resultando de las deformaciones elásticas, se introducen en el material dislocaciones y otros defectos estructurales, con densidad δD =(βFWHM)2/9B212. B es el módulo del vector de Burger que define la dirección de las líneas de dislocación. Experimentalmente, podemos asociar el módulo del vector de Burger con la distancia interplanar a través de la Ley de Bragg, d = λ/2sen θ, obteniéndose así que la densidad de dislocaciones se puede determinar directamente del espectro de DRX mediante la relación,
Estas dislocaciones se forman durante el proceso de relajación elástica a lo largo de las líneas de dislocaciones y son esenciales para estabilizar el crecimiento del grano a medida que éste se forma.
4. Resultados y análisis
El patrón de DRX del semiconductor ternario AgIn5VI8 se muestra en la Fig. 1. A través de un análisis previo determinamos que este patrón corresponde a una estructura cúbica-espinel con parámetro de red a = 10.8217 Å 5. La estructura cúbica-espinel es típica de una clase de minerales llamados espineles de alúmina, cuya fórmula cristalina general es A2+ B 3+O2-. Los cationes A y B se disponen ocupando alternadamente los sitios octaédricos y tetraédricos, mientras que los aniones O, forman una red cúbica-compacta. El perfil de este patrón de difracción se ajusta razonablemente a un perfil Gaussiano, como se nota en uno de los picos característicos del espectro (Figura insertada). Los espectros de AgIn5Se8 y AgIn5Te8 se muestran en las Figs. 2 y 3. Ambos sistemas presentan una estructura tetragonal con parámetros de red a = 5.795224 Å, c = 11.622806 Å para AgIn5Se8 y a = 6.2120 Å, c = 12.4561 Å para AgIn5Te8, y con distorsión tetragonal típica c/a ≅ 2.005, en ambas muestras 5. El perfil teórico que mejor ajusta estos espectros es un perfil Gaussiano, como lo demuestran las curvas continuas en las Figuras insertadas. Como se discutió en la Sec. 3, la forma de línea Gaussiana del espectro de DRX indica que el ensanchamiento de las líneas está determinado principalmente por un campo de micro-deformaciones anisotrópico, que predomina sobre los efectos de tamaño del grano. El ancho de línea a media altura (FWHM), βFWHM, en función del ángulo de difracción, θ, es determinado para cada una de las muestras a partir del perfil Gaussiano y se presentan en la Fig. 4. Los valores de βFWHM corresponden a los picos cuya resolución está bien definida. En todas las muestras se observa que el valor del ancho de línea es constante para ángulos pequeños, hasta un valor crítico θC a partir del cual, βFWHM presenta un incremento monotónico a medida que aumenta el ángulo de difracción. Este comportamiento es también observado en otros compuestos semiconductores policristalinos, tal como el cuaternario AgIn4GaTe87. Nótese que el valor de θC coincide con la posición del pico más intenso en todas las muestras, con un corrimiento desde ≅ 13.65° hasta ≅ 12.39° en la medida que el número atómico, z, aumenta desde 16 hasta 54. Este corrimiento de θC se explica mediante la Ley de Bragg, θC = λ/2d(z), donde se puede verificar que la distancia interplanar calculada en θC satisface la relación, d(S) < d(Se) < d(Te). Las curvas continuas en la Fig. 4 son calculadas empleando la Ec. (5), con los parámetros listados en la Tabla I, obteniéndose una concordancia bastante buena entre la data experimental y la teoría. A modo de referencia, mostramos el límite de Scherrer (línea segmentada) calculado con la Ec. (1) y usando el mismo tamaño de grano en la Tabla I. Tal diferencia es un indicio de las propiedades anisotrópicas del tamaño del grano ó cristalito en materiales policristalinos, es decir, el tamaño del grano es diferente a lo largo de cada dirección de la red cristalina. Ambos parámetros microestructurales (L, ε) aumentan con el número atómico del anión. Estas fluctuaciones en los parámetros microestructurales son generalmente acompañada por dislocaciones cristalinas distribuidas en los planos cristalinos, de acuerdo con la Ec. (6). La densidad de dislocaciones obtenida a partir de los espectros de DRX, se muestra en la Fig. 5 para cada uno de los compuestos. Obsérvese el incremento de la densidad de las dislocaciones, del orden de ≈ 83%, cuando el elemento S(z = 16) es sustituido por los elementos Se(z = 34) y Te(z = 54). Este incremento es precisamenteel número residual de dislocaciones necesarias para estabi- lizar la estructura tetragonal en los granos de AgIn5Se8 y AgIn5Te8. Las curvas continuas en la Fig. 5 corresponden a la cola de una función de distribución Gaussiana de la forma
donde δD(0), δDM, θ0 y Δθ, son parámetros de ajuste. Los valores de estos parámetros de ajuste se presentan en la Tabla II, en función del número atómico del anión. Este resultado, aunque es empírico, nos indica que las dislocaciones elásticas se distribuyen aleatoriamente en los granos del material, con densidades medias 1.633, 3.010 y 2.380 (× 108 mm-2) para S, Se y Te, respectivamente. La función de distribución de estas dislocaciones está asociada al perfil de la línea del espectro de difracción. Tampoco observamos una correlación bien definida entre los parámetros de ajuste y el valor de z.

Figura 1 Patrón de DRX del compuesto AgIn5S8. El perfil de los picos de difracción es en general Gaussiano, tal como se muestra en la Figura insertada para un pico típico (ver curva continua).

Figura 2 Patrón de DRX del compuesto AgIn5Se8. El perfil de los picos de difracción es en general Gaussiano, tal como se muestra en la Figura insertada para un pico típico (ver curva continua).

Figura 3 Patrón de DRX del compuesto AgIn5Te8. El perfil de los picos de difracción es en general Gaussiano, tal como se muestra en la Figura insertada para un pico típico (ver curva continua)
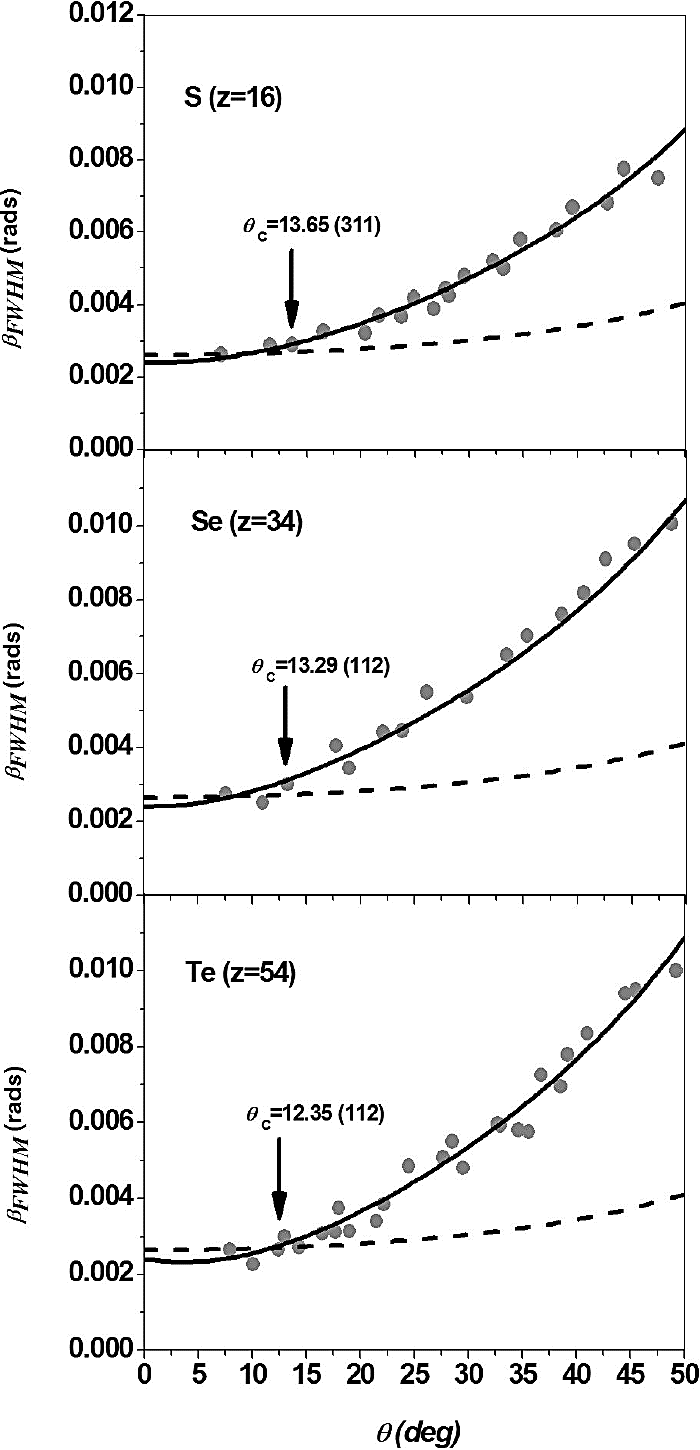
Figura 4 Ancho de línea a media altura (βFWHM) en función del ángulo de difracción para cada muestra. Las líneas continuas son ajustes numéricos con la ecuación modificada de Scherrer (5). Los parámetros de ajuste se listan en la Tabla I. El ángulo θC es el valor para el cual la formula convencional de Scherrer deja de ser valida.
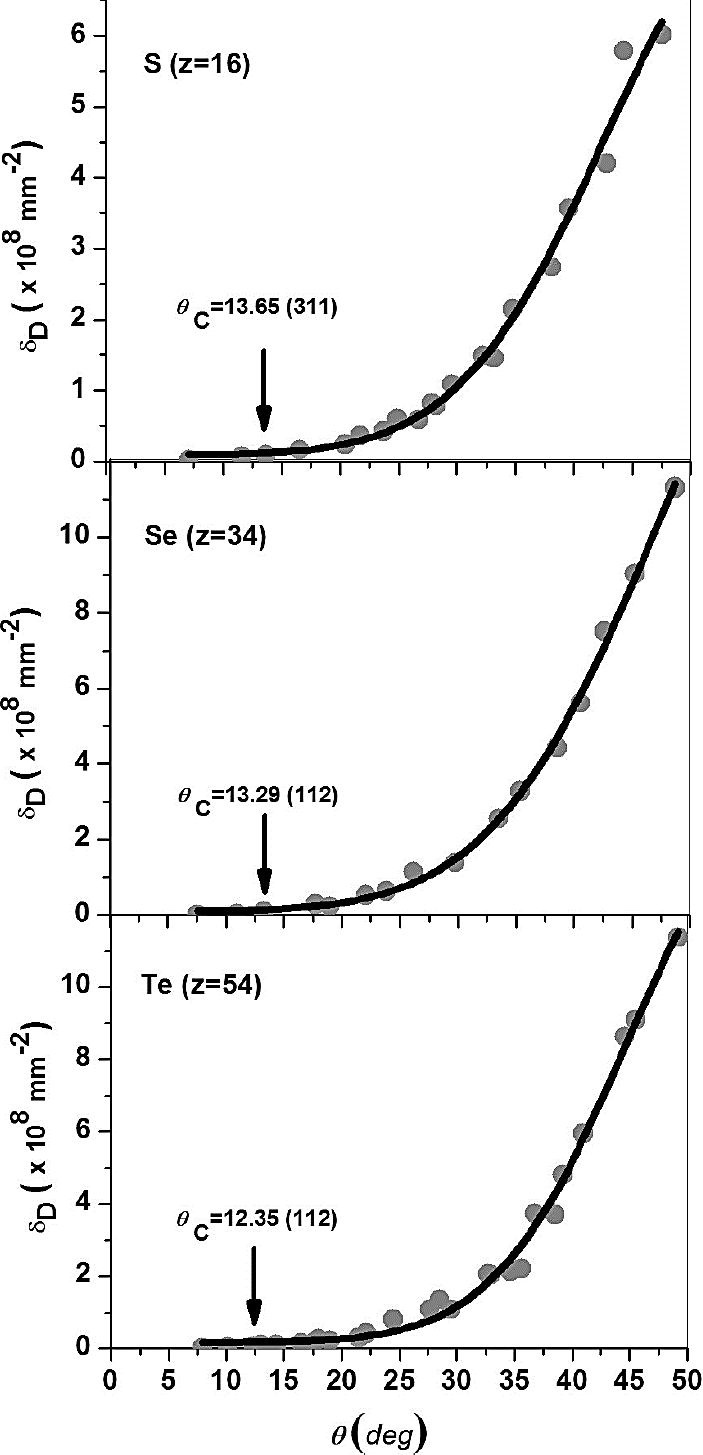
Figura 5 Densidad de dislocaciones (δD) en función del ángulo de difracción para cada muestra, determinada a partir de la Ec. (6) . Las líneas continuas corresponden a la cola de una función de distribución Gaussiana, como se describe en el texto. Los parámetros de ajuste se listan en la Tabla II.
Tabla I Tamaño medio de grano y constante de microtensión para AgIn5VI8.
| Z | L(nm) | ε(%) |
| 16 | 245 | 0.15 |
| 34 | 258 | 0.22 |
| 54 | 262 | 0.24 |
Conclusiones
Las propiedades microestructurales de compuestos semiconductores policristalinos AgIn5VI8 (VI=S, Se, Te) mediante DRX. Para esto, el ancho de línea del perfil de difracción de RX, βFWHM, es estudiado en el marco teórico de un método de análisis de Tensión/Tamaño. El análisis, permite concluir lo siguiente:
Ancho de línea satisface la ecuación modificada de Scherrer, para un perfil de difracción Gaussiano.
Los parámetros que caracterizan la microestructura de los materiales son: tamaño medio del grano, constante de microtensión y densidad de dislocaciones cristalinas. Estos dependen del número atómico (radio iónico) del anión VI.
La densidad de dislocaciones cristalinas en los granos se incrementa en el orden del ≈ 83%, cuando el anión Se es substituido por los aniónes Se y Te. La densidad de dislocaciones es una variable aleatoria y se distribuye de acuerdo a una función de distribución Gaussiana.
El perfil de los picos de difracción y la densidad de dislocaciones es similar. Con esto, el podemos atribuir el origen del perfil de difracción a la forma en que se distribuyen las dislocaciones elásticas en los planos cristalinos contenidos en el grano.
La detección y cuantificación de microtensiones y defectos estructurales en compuestos policristalinos y sistemas granulares, es en general, una tarea compleja que requiere de técnicas experimentales altamente sensibles, y estudios teóricos más fundamentales. Sin embargo, la información reportada en este trabajo puede ser de relevancia para la aplicación de los compuestos ternarios AgIn5VI8 en diversos procesos semiconductores.











 nova página do texto(beta)
nova página do texto(beta)


